マイクロエレクトロニクスシンポジウム(MES2025)からTSV形成におけるめっきプロセスに関する発表をご紹介
- 2025年11月8日
- 読了時間: 6分
こんにちは、営業部のTZです。
この度、エレクトロニクス実装学会が主催するマイクロエレクトロニクスシンポジウム(MES)に参加させていただきました!
MESは、実装技術の専門家が全国から集まって開催される関西エリアの年に一度の大きなイベントです。今年は9月3日から5日までの3日間、大阪大学中ノ島センターで開催されました。過去最高の560名が参加し、会場は熱気に包まれ、業界の盛り上がりを肌で感じることができました。
詳細は、MES2025のホームページをご覧ください。
今回は、MESで発表された研究テーマの中から、弊社と関係のあるシリコン貫通ビア(TSV)に関連する2つの注目トピックをご紹介します。
東設のめっき装置が量子コンピューターの研究開発に貢献
1つ目のトピックは、産業技術総合研究所(産総研)の研究発表です。
次世代コンピューターとして注目を集める量子コンピューターの開発において、産総研とNECの共同研究成果が発表されました。発表の題目は、「超電導量子アニーリング回路の空洞共振モードを抑制するためのTSV・裏面回線工程」です。
その中で、当社のめっき装置が超伝導量子アニーリング回路の重要な製造工程に使用され、大規模化の鍵となる課題解決に寄与したことが報告されました。
1.背景:量子コンピューターの大規模化に立ちはだかる課題
量子アニーリング方式は、組み合わせ最適化問題を効率的に解く手法として期待されており、現在は100量子ビット以上の大規模化に向けた開発が進められています。
しかし、回路が大規模化すると「空洞共振モード」と呼ばれる問題が顕在化します。これは、回路の動作周波数(10~20 GHz)の信号がシリコン基板内部で定在波を生じ、ノイズ源として回路全体に悪影響を及ぼす現象です。
これを抑えなければ、大規模な量子コンピューターは安定して動作できません。
2.解決策:via-first TSVと裏面配線の導入
研究チームは、この空洞共振モードを抑制するために、via-first方式によるTSV(Through-Silicon Via)と裏面配線形成工程を開発しました。
TSVと裏面配線を導入することで、基板内の定在波が分割され、回路の動作周波数帯(10・20 GHz)から外れる
量子アニーリング回路を損傷させないよう、回路形成の前工程でTSVを形成
という工夫が施されています。

3.成果:低温実験で効果を確認
作製したTSV付き試料を極低温(4 K、約-269℃)で評価したところ、
TSVなし:14.5 GHzや18.5 GHz付近で強い共振が発生
TSVあり:動作周波数付近で大きな共振は観測されず
という結果が得られ、TSVと裏面配線が空洞共振モードの抑制に有効であることが実証されました。
4.弊社めっき技術の役割
今回のTSV形成では、弊社のめっき装置が重要な役割を担いました。
TSV寸法:直径 約60 μm、深さ 約400 μm(高アスペクト比)
導体材料:TiN(超伝導特性)、Cu(電解めっき充填)
プロセス:Si深掘りエッチング → TiN/Cu成膜 → 電解Cuめっきによる完全充填
深く狭いTSVを均一かつ確実にCuで充填する技術は難易度が高く、当社の装置が研究成功の鍵を支えました。これは、極低温で動作する大規模量子回路を可能にするための不可欠な基盤技術です。
今回の成果は、TSV形成により、大規模量子アニーリング回路の実現を阻んできたノイズ問題を克服したという点で大きな意義を持ちます。

東設製 研究開発・試作用
フェイスアップ式めっき装置
無電解めっきCoMnによるTSV対応拡散バリア膜技術
2つ目のトピックは、弊社が過去に科学技術振興機構(JST)のA-STEPプロジェクトによる共同開発に携わらせていただいた、関西大学システム理工学部からの発表「無電解めっきCoMnによるTSV対応拡散バリア膜形成技術」について。
1.背景と課題
半導体の高性能化には「3次元集積化」が欠かせません。
その中核となるTSVは、シリコン基板に垂直方向の配線を形成する技術です。
ただし、TSV内部に銅(Cu)を埋め込む際、銅の拡散を防ぐバリア膜が必要となります。
従来はスパッタによるバリア層とCuシード層が用いられてきましたが、TSVの微細化・高アスペクト比化に伴い、膜の均一性や被覆性に大きな課題がありました。
これまでの無電解めっき材料(CoBやCoWB)は、
高温アニール後のCu拡散防止性能が不十分
SiO2酸化膜との密着性が低い
といった制約が残っていました。
2.新しいアプローチ:CoMn合金の無電解めっき
研究グループは、マンガン(Mn)が熱処理後に酸化物やシリケートを自己形成し、銅拡散を抑える効果がある点に着目し、無電解めっきでコバルトマンガン(CoMn)合金膜を形成する技術を開発しました。
還元剤にはヒドラジン水和物を採用。これにより従来のDMAB還元系に比べて不純物混入を抑制し、低抵抗の金属膜が得られました。
めっき直後の抵抗率:60 μΩcm
400℃アニール後:25 μΩcmまで低下(結晶粒成長の効果)
従来材料に比べ、電気特性の大幅な改善が確認されています。
3.バリア特性とそのメカニズム
積層膜(TiN/Cu/CoMn/SiO2/Si)を作製し、350℃で30分アニール後のCu拡散挙動を評価しました。
従来のCoWBではCuがSi基板まで拡散 → シリサイド形成が示唆
Mn濃度0.01MのCoMnでも拡散を完全には防止できず
Mn濃度0.025MのCoMnではCu拡散を完全に抑制
XPS分析の結果、アニール後のCoMn膜では界面にMnが偏析し、Cu側およびSi側の両界面でMn濃度ピークが観察されました。これにより形成された薄いCoMnOx層が、Cu拡散を効果的に阻止していると考えられます。
4.TSVへの適用結果
直径4μm、深さ24 μmのTSVに堆積したところ、上部200 nm、中部170 nm、下部150 nmと、コンフォーマル(均一)な堆積が確認されました。これは、めっき浴に微量の抑制剤を加えることで実現しています。
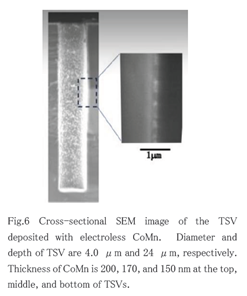
ヒドラジン還元によるCoMn無電解めっきは、低抵抗率かつ高いCu拡散バリア性を両立。
高温プロセス後もCuのSi基板への拡散を抑制できることを実証。
TSV形状でも均一な膜形成が可能であり、量産適用に向けた有効性を確認。
この成果は、低コストかつ高信頼性のTSV製造を可能にする基盤技術として、今後の3次元集積化技術の進展に大きく貢献すると期待されます。
お客様のTSV、ビアフィリング形成プロセス開発に東設はめっき装置だけじゃない、プロセスも合わせて提案いたします!
今回の記事では、MES2025から、TSV形成プロセスについての2つの発表をご紹介いたしましたがいかがでしたか?
弊社は、量子コンピューター、3次元半導体、先端パッケージング分野など向けに、研究開発から量産まで、お客様のニーズに応える高性能なめっき装置の設計・開発を通じて、未来社会の基盤となるテクノロジーの進化に貢献してまいります。
今後も、お客様のお役に立てるよう、努力してまいります。
こちらの関連記事もご参照ください。
「シリコン貫通電極(TSV)形成に貢献するめっき技術開発のお話」
「Cuめっきビア内気泡除去の強い味方「Livalley」【脱気システム活用術】」
「めっき受託加工メーカー様向けめっき装置製品のご提案」
「めっきによるオールウェット微細配線の形成技術開発のお話」
めっきプロセスのデモ評価や技術的なご相談も承っておりますので、お気軽にお問い合わせフォームよりご連絡ください。
東設に興味を持っていただいた方はこちらから。
↓
参考情報:
MES2025(第35回マイクロエレクトロニクスシンポジウム), 大阪大学中ノ島センター, 2025年9月 発表要旨集




コメント